周三(15 日),ICEPT 2021 電子封裝技術國際會議正式開幕,華為的 Tonglong Zhang 發表主題演講表示,封裝級系統(package level system)是未來高性能計算(HPC)和網絡交換系統的發展趨勢。
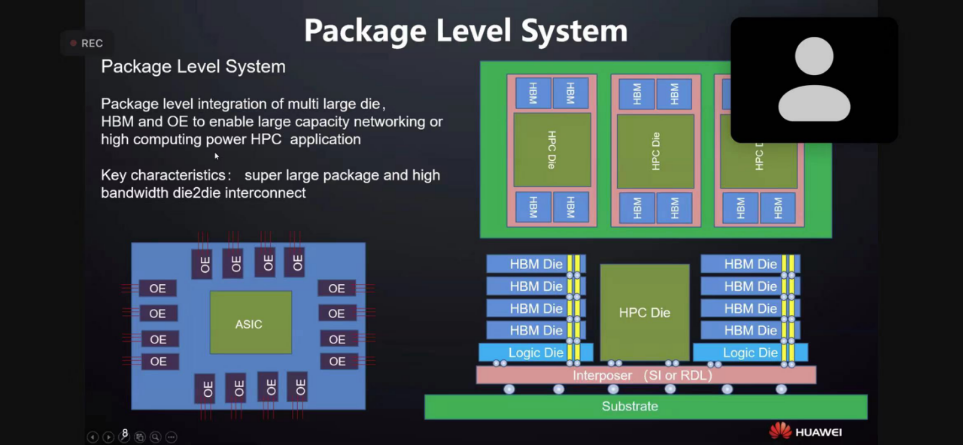
據 Tonglong Zhang 介紹,當前,HPC 芯片有三大發展趨勢:1、AI 應用高數據吞吐量帶來更高的互聯密度需求;2、更多的芯片集成在封裝中以提高計算能力,帶來超大尺寸封裝需求;3、IC 封裝間的光數據傳輸。
在此趨勢下,封裝級系統技術應運而生,其特點為超大尺寸封裝和超寬帶的雙模互聯,具備更高的互聯密度更高、更高的數據帶寬、較短的互聯距離、更低的數據傳輸能耗與成本。典型的例子包括臺積電的 InFO-SoW、英偉達的 ISSCC 2021 超大尺寸封裝等。
不過 Tonglong Zhang 也指出,封裝級系統仍然面臨諸如工藝、可靠性、散熱、PI、SI 等挑戰。此外,散熱和功率傳輸將是限制 3D 封裝的兩個關鍵因素。“產業界需要共同努力,應對挑戰,推動摩爾定律向前發展。”
特別提醒:本網信息來自于互聯網,目的在于傳遞更多信息,并不代表本網贊同其觀點。其原創性以及文中陳述文字和內容未經本站證實,對本文以及其中全部或者部分內容、文字的真實性、完整性、及時性本站不作任何保證或承諾,并請自行核實相關內容。本站不承擔此類作品侵權行為的直接責任及連帶責任。如若本網有任何內容侵犯您的權益,請及時聯系我們,本站將會在24小時內處理完畢。
 站長資訊網
站長資訊網